BW-Series: White Light Interferometric Microscope System

-
Accurate sub-nano-surface profiler with non-contact measurement
Nikon’s proprietary scanning-type optical interference measurement technology achieves 1 picometer (pm) height resolution. Nikon offers a variety of optical microscopes as measurement systems to suit a wide range of measurement applications.
Key benefits
Superior measurement performance
- Realizes 0.1 nm-level measurements of ultra-smooth surfaces with neither averaging nor filtering process.
- Enables measurements with the same height resolution in a wide range of magnifications.
- Enables measurement of both smooth and rough surfaces without changing measurement mode or optical filters.
- Captures both an all-in-focus image and a surface height image.
Wide range of observation methods
- The system can be used as an optical microscope. Brightfield, polarizing, DIC and fluorescenceobservations are all possible.
Sub-nano-level measurement in a wide range of magnifications
Type: BW-D501 system
Subject: Silicon Carbide (SiC) Wafer

Sa 0.483nm
0.645nm Sq
Sz 7.460nm
![]()
Sa 0.302nm
0.401nm Sq
Sz 11.187nm
![]()
Sa 0.144nm
0.545nm Sq
Sz 121.859nm
![]()
Sa 0.391nm
0.495nm Sq
Sz 3.934nm
![]()
Sa 0.306nm
0.398nm Sq
Sz 3.264nm
Precise surface measurements for micrometer-range rough surfaces
Type: BW-A501 system
Subject: Membrane of synthesized diamond using in-liquid plasma chemical vapor deposition
Photos courtesy of: Ph.D. Hiromichi Toyota, Ehime University Graduate School of Science and Engineering

Height calibration with the NIST-certified VLSI standard

BW-D501 system
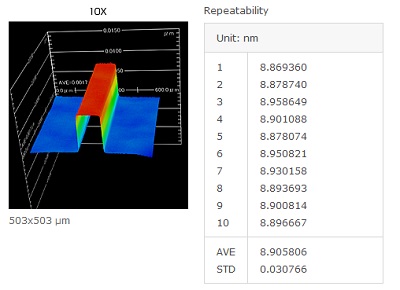
Specifications: White Light Interferometric Microscope System
| High Pixel Resolution Model | ||||||
|---|---|---|---|---|---|---|
| BW-S501 | BW-S502 | BW-S503 | BW-S505 | BW-S506 | BW-S507 | |
| Measurement optical system | Focus Variation with White Light Interferometry (FVWLI) | |||||
| Height resolution (algorithm) | 1pm (0.001 nm) | |||||
| Step height measurement reproducibility | σ: 8nm / 8μm step height measurement | |||||
| Number of pixels | 2046 x 2046, 1022 x 1022 (selectable via software) | |||||
| Height measurement time | 38 s, 16 s / 10 μm scan | |||||
| Height measurement range | < 90 μm | < 20 mm | < 90 μm | < 20 mm | ||
| Measurement field size (using 2.5X) | < 4448 x 4448 μm* | |||||
| Piezo actuator | Objective lens driven | Nosepiece driven | ||||
| Z axis | Manual | Electric | Manual | Electric | ||
| XY axis | Manual | Electric | Manual | Electric | ||
| Software | Bridgelements® software modules | |||||
| High Speed Model | ||||||
|---|---|---|---|---|---|---|
| BW-D501 | BW-D502 | BW-D503 | BW-D505 | BW-D506 | BW-D507 | |
| Measurement optical system | Focus Variation with White Light Interferometry (FVWLI) | |||||
| Height resolution (algorithm) | 1 pm (0.001 nm) | |||||
| Step height measurement reproducibility | σ: 8nm / 8μm step height measurement | |||||
| Number of pixels | 510×510 | |||||
| Height measurement time | 4 s / 10 μm scan | |||||
| Height measurement range | < 90 μm | < 20 mm | < 90 μm | < 20 mm | ||
| Measurement field size | < 2015 x 2015 μm * | |||||
| Piezo actuator | Objective lens driven | Nosepiece driven | ||||
| Z axis | Manual | Electric | Manual | Electric | ||
| XY axis | Manual | Electric | Manual | Electric | ||
| Software | Bridgelements® software modules | |||||
* The range can be extended by changing the relay lens or by stitching.







